Этот процесс является получением эпитаксиальных слоев полупроводников, с помощью применения метода осаждения из парогазовой фазы. В большинстве случаев используется в приборах, применяющих кремниевую, германиевую, арсенид-галлиевую технологию, а также интегральными схемами.
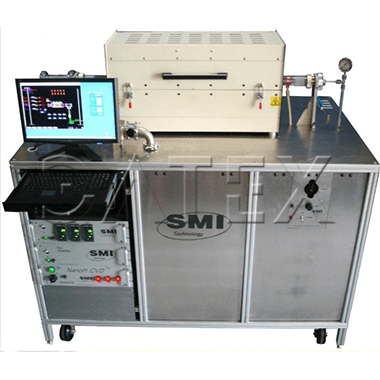
Газофазная эпитаксия
Процедура газофазной эпитаксии может производиться в обстоятельствах атмосферного давления либо при высоком вакууме, которые должны находиться в специальном реакторе, расположенном вертикально или горизонтально. В качестве реагента выступает поверхность полупроводниковых пластинок (подложка), которые разогревают до 350-1200 градусов (необходимая степень нагрева зависит от уровня давления внутри камеры, метода осаждения и скорости возникновения реакции конкретного объекта). Для осуществления разогрева подложки применяется инфракрасное излучение, индукционный либо резистивный способы. Если температура нагрева ниже необходимой, для конкретных обстоятельств и условий осаждения, то на поверхности объекта формируется поликристаллический слой. Хотя, такая особенность позволяет уменьшить ширину переходной диффузионной части между эпитаксиальными слоями и подложками, что в конечном итоге приводит к ухудшению общих характеристик создаваемых устройств.
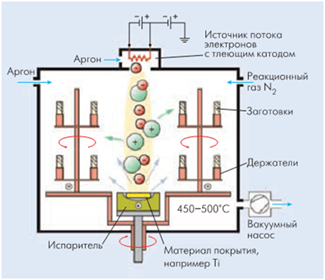
При помощи метода газофазной эпитаксии, получить необходимый слой кремния можно двумя способами:
- С помощью водородного восстановления тетрахлорида кремния, трихлорсиланом либо дихлорсиланом.
- Благодаря пиролитическому разложению моносилана.
Хлоридный метод эпитаксии
Если в качестве источника эпитаксии применяется тетрахлорид кремния, то его суммарную реакцию можно записать следующей формулой: SiCl4+2H2(сухой)=Si+4НСI
Получаемую реакцию возможно перенаправить в обратную сторону, для этого необходимо повысить температуру нагрева либо увеличить концентрацию хлорида. Что касается реакции восстановления дихлорсилана, а также трихлорсилана, то они имеют промежуточный характер в процессе реакции водородных восстановлений тетрахлорида кремния. Благодаря данным особенностям, применяя эти элементы как источники кремния, существенно повышается технико-экономический показатель процедуры. Наряду с этим для того, чтобы определить необходимый источник, нужно учитывать обстоятельства используемых веществ. Дело в том, что вещества трихлорсилан и тетрахлорид кремния имеют жидкое состояние в условиях комнатной температуры, а дихлорсилан при тех же условиях является газообразным. В большинстве случаев, вещество трихлорсилан используется только на тех предприятиях, где его изготавливают, так как он достаточно опасен как при хранении, так и при перевозке. Тетрахлорид кремния более стабилен и считается универсальным для применения.
Для наглядного примера, далее приведена система реакции процесса водородного восстановления, с применением тетрахлорида кремния:
- SiCl4 + H2 <—> SiHCl3 + HCl;
- SiHCl3 + H2 <—> SiH2Cl2 + HCl;
- SiH2Cl2 <—> SiCl2 + H2;
- SiHCl3 <—> SiCl2 + HCl;
- SiCl2 + H2 <—> Si + 2HCl.
Для использования такого метода существует ряд определенных ограничений, которые заключаются в том, что наносить эпитаксиальную пленку на сапфировые подложки не получится, так как хлористый водород создает отрицательную реакцию с подобными подложками и начинает травить сапфир.
Для того, чтобы провести метод эпитаксии селановым способом, используется следующая формула: SiH4=Si+2H2.
Для проведения данной реакции необходимо разогреть материал до температуры 1050 градусов. Разложение при таком градусе, в отличие от хлоридного метода, способствует замедлению диффузии и снижает вредоносный эффект автоматического легирования. За счет данных особенностей, используя такой метод возможно получение более резких переходов между поверхностями слоев.

Легирование и автолегирование газофазной эпитаксии
Существуют разные компоненты и процессы, с помощью которых осуществляется газофазная эпитаксия. Среди наиболее распространенных вариантов используются:
Легирование. При таком создании эпитаксиального слоя процедура производится параллельно с разрастанием слоев реактивным методом (это происходит с помощью добавления легирующих примесей в паро-газовую смесь).
Проведение эпитаксии с помощью газообразных примесей. К таким веществам относятся фосфин, диборан и арсин, которые достаточно нестабильны в момент их хранения и обладают высокой степенью токсичности. Если такие характеристики приемлемы для производства, их востребованность увеличивается, так как газообразные примеси дают возможность создавать упрощенный вариант установок.
Метод газофазной эпитаксии с жидкими примесями. Из-за того, что для проведения такой реакции жидкость нужно заливать в испарительный либо барботажный термостатированный дозатор, ее концентрацию достаточно сложно регулировать. Для процедуры испарения используемой жидкой примеси, в дозатор подается газ-носитель H2.
Газофазная эпитаксия с твердыми примесями. Для того, чтобы распылить твердую форму легирующих примесей, применяется искровой разряд, после чего подготовленное вещество посредству водорода переносится в реакционную камеру или испаряется в зоне печи с низкой температурой (чтобы организовать такой метод эпитаксии печь должна иметь две зоны).
Автолегирование. В процессе проведения практически любой газофазной эпитаксии возникает процедура автолегирования, действие которого обуславливается переносом примесей из сильно легирующих слоев в слабо легирующие. Механизм, который способствует такой процедуре называется диффузией.